
“大部分安顺扫描电镜实验室对于纳米尺寸的准确测量,要求没有那么严格,比如线宽或颗粒大小到底是105nm还是95nm,似乎不太重要,大部分用户关心统计趋势而不是某一个值的准确值。但在半导体领域,105nm或95nm的误差,是不可接受的。这就提出了一个问题,我们如何才能测准?本文讨论了SEM成像参数/仪器校准以及电子束-样品相互作用模型对准确度的影响。”
自安顺扫描电子显微镜(SEM)问世以来,经历了巨大的演变,已成为许多科学和工业领域的重要研究工具。高分辨SEM特别适合定性和定量方面的应用1,尤其是纳米技术和纳米制造。备注1:SEM定量方面应用主要是在半导体行业的测量或计量。

在第一张SEM图像被记录之前,人们最先提出的问题之一很可能是:"......这个东西到底有多宽?"
在过去的几年里,这个问题的答案精度有了很大的提高,特别是如今CD-SEM已被用作半导体加工生产线上的主要测量工具,用于监控生产过程。半导体生产的明确需求推动了SEM设备及其功能的快速发展。在过去20年左右的时间里,通过半导体行业大量的研发资金投入,SEM仪器制造商极大地提高了这些仪器的性能。所有用户都能从这些投资中受益匪浅,尤其是在使用SEM进行定量测量时。但是,这些数据到底有多好或者多准确?
SEM 计量/测量
有人曾经说过:"如果我想得到准确的尺寸,我就把被测样品交给SEM操作员。如前所述,SEM是一种仪器,人们常常想当然地认为它是正确的,所产生的任何测量值也是正确的。在过去的几年里,SEM的测量精度有了极大的提高,CD-SEM也已经成为半导体加工生产线上监控制造过程的主要工具之一。但是,事实还是会被掩盖,我们必须小心谨慎。

使用任何科学仪器进行定量测量,都需要比想象中更加谨慎和深入了解。定量测量所依据的物理原理必须在测量中得到充分理解和说明。例如,在光学中,必须克服衍射的影响;在扫描探针显微镜中,必须考虑扫描探针针尖的形状;在SEM中,必须考虑测量信号的产生、电子束参数、样品充电以及电子束与试样的相互作用。如果不仔细检查就认为一切正常,很容易得出错误的数据。
如今,使用SEM进行的测量主要有三种,尤其是在半导体制造领域。如图5所示,最简单的是间距(或位移)测量,第二种是结构宽度(临界尺寸或线宽测量)。不久之后,第三种测量方式也将成为主流,即轮廓正三维(3D)测量(Orji 2011)。不过,由于三维或轮廓计量学仍处于发展阶段,因此本文不对其进行讨论。
间距测量
如果我们将两条线分开一定的距离,那么测量第一条线的前缘到第二条线的前缘的距离就定义了间距或位移。间距测量中的一些系统误差(由于振动、电子束相互作用效应等)在两个前缘上都是相同的;这些误差,包括试样与电子束相互作用的影响,被认为是可以忽略的(Jensen,1980;Postek,1994)。因此,与边缘相关的误差有相当大的一部分不在用于计算间距的等式中。成功测量的主要标准是测量的两条边缘必须在所有方面都相似。
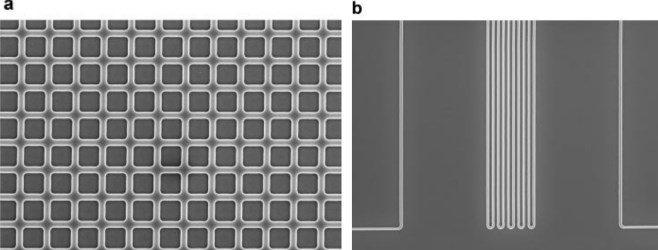
平均多条线可以最大程度地减少校准样本中边缘效应造成的影响。使用精确的间距标准可以轻松完成SEM放大校准。RM8820有许多间距结构可用于此过程;可根据要求提供计算间距的软件程序(Postek,2010 )。
宽度测量
任何纳米结构、纳米粒子或半导体线路的宽度测量都很复杂,因为上述的许多系统误差现在都是相加的。因此,在测量中还包括来自两个边缘的边缘检测误差。SEM的放大倍率不应校准为宽度测量值。宽度测量会将这些误差加在一起,导致测量不确定性增加。
此外,由于电子束-样品的相互作用效应不同,这些误差也因样品而异。使测量更加复杂的是,每台SEM都会因操作条件和电子收集特性而产生其特有的仪器效应。实际上,通过这种测量方法,我们并不知道图像中边缘的准确位置,更重要的是,不知道它是如何随仪器条件而变化的。
上文提到的实验室间研究也证明,参与者报告的200 nm名义线宽的宽度测量值有的偏大了60%之多(Postek,1993)。造成这些结果的影响因素很多,尤其是用于解释所获图像或数据的测量算法类型。因此,基于宽度测量的校准包含许多误差成分,需要开发和使用电子束-试样相互作用模型。
总结
校准良好的现代CD-SEM仪器能够进行极高分辨率和高度精确的测量。由于对SEM进行了许多改进,可以使用适当的校准样本以较高的置信度精确校准放大倍率(或刻度)。测量精度一般可以达到或优于0.2nm (1σ),在半导体生产等许多应用中,这样的高精度已经足够。










